Application Notes für Ihren Anwendungsfall
Allgemeine Übersicht: Silikonfreie Gap Filler von KERAFOL®(GFU-Serie)

Mehr...
Diisocyanate sind in vielen Polyurethan-Produkten enthalten und unterliegen seit 2023 strengeren REACH-Vorgaben. Dies betrifft einige auf dem Markt befindliche silikonfreie Gap Filler, welche in verschiedenen Elektronikanwendungen zum Einsatz kommen, gerade dann wenn Silikone nicht eingesetzt werden können. Die Application Note erklärt die ensprechenden Hintergründe und klärt auf, welcher silkonfreie Gap Filler von den Regelungen nicht betroffen ist.
Anwendungsbereiche KERABSORB
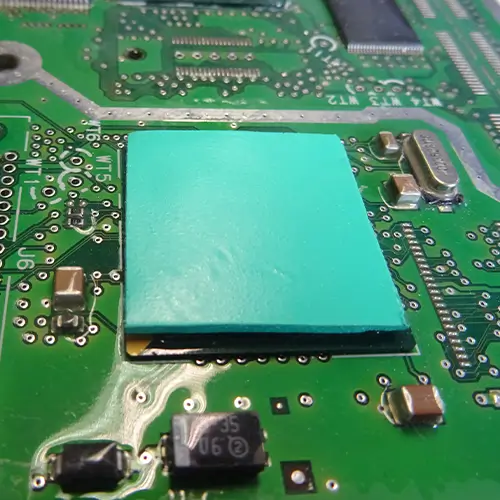
Mehr...
Elektronische Systeme erfordern zunehmend Materialien, die sowohl elektromagnetische Störungen minimieren als auch Wärme effizient ableiten. Mit Kerabsorb bietet Kerafol ein Material, das die Eigenschaften eines klassischen Gap Pads mit denen eines EMI-Absorbers kombiniert.
Die Application Note zeigt, wie Kerabsorb zuverlässige Dämpfung im Hochfrequenzbereich, hohe Wärmeleitfähigkeit und definierte Isolationsfestigkeit in einem einzigen, einfach integrierbaren Material vereint.
Anwendungsbereiche KERAMOLD®

Mehr...
Die effiziente thermische Anbindung von aktiven Komponenten an einen Kühlkörper ist eine der zentralen Herausforderungen in der Leistungselektronik. KERAMOLD® ermöglicht dank spritzgegossener 3D-Geometrien eine direkte, formschlüssige Verbindung zwischen Bauteilen und Kühlkörpern, ohne dass zusätzliche Bearbeitungsschritte am Metall erforderlich sind.
Die Application Note zeigt, wie KERAMOLD® neue Freiheitsgrade für das Design thermischer Schnittstellen eröffnet, Kosten senkt und gleichzeitig den thermischen Übergangswiderstand minimiert.
Battery Management System

Mehr...
Unsere Case Study zeigt, wie das Overmolding von PCBs mit KERAMOLD® 20 (W/mK) die Bauteiltemperatur signifikant reduziert und gleichzeitig mechanischen Schutz sowie elektrische Isolation bietet – bei deutlich verkürzten Prozesszeiten gegenüber Conformal Coating oder Verguss.
Efficient oxygen supply in fish farming – advantages of ceramic aeration discs

Mehr...
In modern aquaculture, a reliable oxygen supply is essential for the growth and health of fish. Conventional aeration systems often reach their limits in terms of efficiency and performance. Ceramic membrane discs enable significantly more effective oxygen transfer and sustainably improve process stability and water quality.
GFL 2400 SL
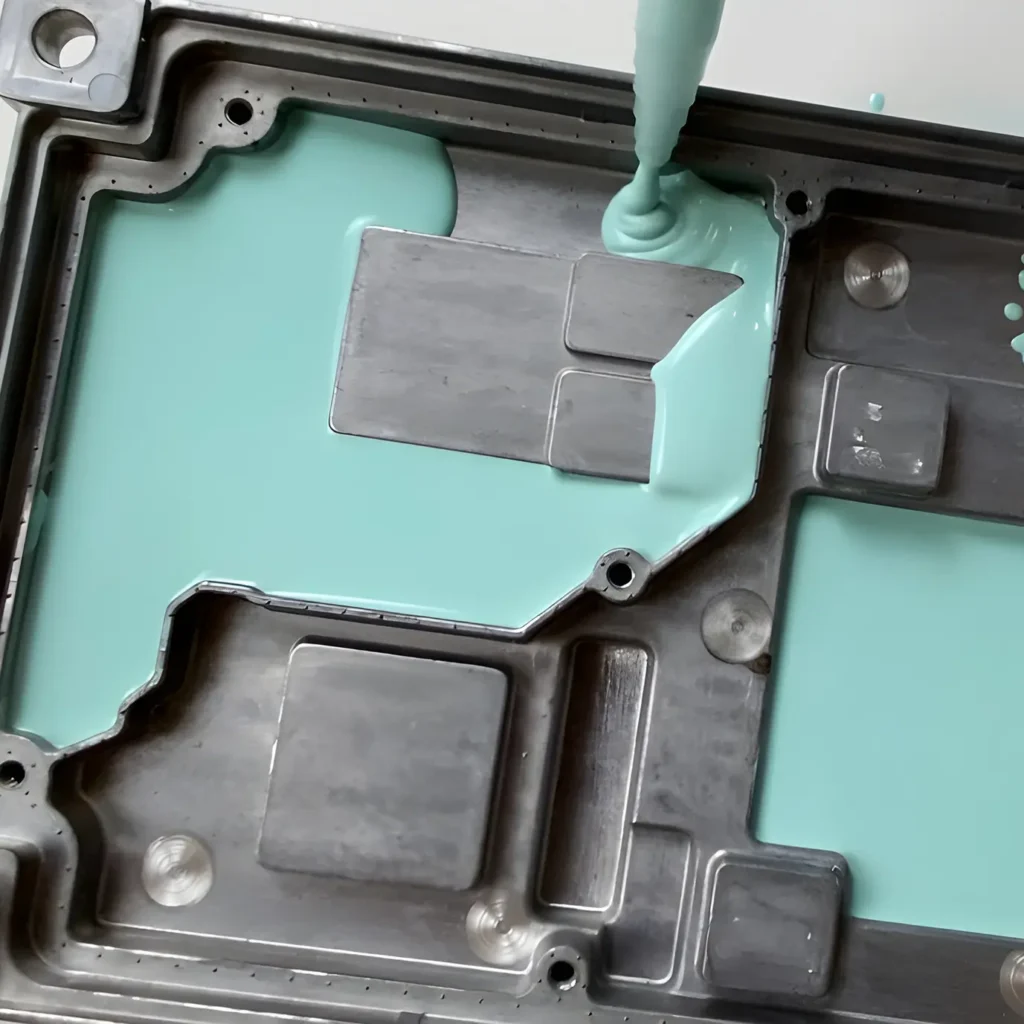
Mehr...
Steigende Leistungsdichten und immer kompaktere Bauformen erhöhen die Anforderungen an das thermische Management moderner Elektronik erheblich. Gefragt sind Wärmeleitmaterialien, die selbst bei geringsten Spaltmaßen zuverlässige, homogene und sichere Schichten bilden. Die silikonbasierte Dünnvergussmasse GFL 2400 SL wurde genau für diese anspruchsvollen Anwendungen entwickelt.
GFL 3035 ultracold

Mehr...
In Luft- und Raumfahrt sowie im Militär- und Verteidigungsbereich sind elektronische Baugruppen extremen thermischen Belastungen ausgesetzt. Hohe Leistungsdichten und begrenzter Bauraum erfordern Wärmeleitmaterialien, die Wärme effizient ableiten und ihre mechanischen sowie elektrischen Eigenschaften über einen großen Temperaturbereich stabil halten. Die GFL 3035 ultracold wurde speziell für diese Anforderungen entwickelt.
GFL 3055

Mehr...
Moderne Elektroniksysteme erreichen stetig höhere Leistungsdichten und erzeugen dabei zunehmend Wärme. Damit Bauteile auf Platinen dauerhaft stabil arbeiten, müssen sie effizient gekühlt, elektrisch isoliert und mechanisch geschützt werden. Der GFL 3055 Gap Filler vereint hohe Wärmeleitfähigkeit mit zuverlässiger Isolation und Flexibilität für extreme Einsatzbedingungen.
Graphitfolien

Mehr...
Insbesondere zur Kontrolle von Thermal-Runaway-Szenarien. Diese Case Study zeigt, wie hochwärmeleitende Graphitfolien von Kerafol in modular aufgebauten Batteriespeichern eingesetzt werden, um Wärme effizient zu verteilen, kritische Temperaturspitzen zu reduzieren und den Energieübertrag auf benachbarte Zellen zu verlangsamen. Am Beispiel eines großskaligen Batteriesystems für maritime Anwendungen wird dargestellt, wie Graphitfolien zur Betriebssicherheit, Langlebigkeit und Nachhaltigkeit moderner Energiespeicher beitragen.
Hybridkeramiken für High-Voltage E-Heater

Mehr...
Bei leistungsstarkes Wide Band Gap Halbleiter wie SiC-oder GaN erfolgt die Wärmeabfuhr meist über die Chipoberseite. Die Application Note zeigt, wie Hybridfolie und Hybridkeramik als zusätzliche Materialoptionen neue Gestaltungsmöglichkeiten im Top-Side-Cooling eröffnen – insbesondere dort, wo thermische Performance, Isolation und Aufbauvarianten flexibel kombiniert werden sollen.
Ein kompakter Überblick für Entwickler, die ihr TIM-Portfolio um weitere Lösungsansätze erweitern möchten.
KERAMOLD®

Mehr...
Elektronikanwendungen erfordern zunehmend Lösungen, die Schutz und effiziente Wärmeableitung kombinieren. KERAMOLD® bietet hierfür einen neuen Ansatz: ein wärmeleitfähiges Spritzgussgranulat, das funktionale Integration und thermisches Management miteinander verbindet.
Die Application Note zeigt, wie sich mit KERAMOLD® neue konstruktive Möglichkeiten für moderne Elektronikmodule erschließen lassen – von der Bauteilgestaltung bis zur Systemintegration.
KERAMOLD® – Einsatz bei E-Motoren

Mehr...
Unsere Case Study vergleicht blanke Wicklungen, klassische Vergussmaterialien und Overmolding mit KERAMOLD® 20 unter realistischen Betriebsbedingungen auf dem Motorprüfstand.Ergebnis: Overmolded Motoren zeigen eine signifikant verbesserte thermische Performance und erreichen kritische Temperaturen deutlich später als vergossene oder bare Designs.
KP 100

Mehr...
In modernen elektronischen Anwendungen steigen die Anforderungen an Wärmeleitmaterialien stetig. Leistungsstarke Komponenten sind zunehmend extremen Temperaturwechseln ausgesetzt, wodurch klassische Wärmeleitpasten und PCM oft an ihre Grenzen stoßen. Genau hier setzt die neu entwickelte KP 100 an und gewährleistet auch unter anspruchsvollen Bedingungen eine dauerhaft zuverlässige Wärmeübertragung.
Optimized High-Temperature Processes in Powder Metallurgy Using Structured Sintering Plates from KERAFOL®

Mehr...
In powder metallurgy, the demands on process stability, reproducibility, and efficiency are continuously increasing, especially in high-temperature applications. Conventional sintering aids often reach their limits. Structured ceramic sinter plates from KERAFOL<sup>®</sup> enable precise part positioning and significantly improve process reliability and cost-effectiveness.
Polaris 3000

Mehr...
In Luft- und Raumfahrt sowie Verteidigung gelten höchste Anforderungen an Wärmeleitmaterialien zur Kühlung sensibler Elektronik. Sie müssen auch unter extremen Temperaturen stabile thermische, mechanische und elektrische Eigenschaften gewährleisten. Polaris 3000 erweitert den Einsatzbereich auf −90 °C bis +200 °C und erfüllt damit selbst strengste militärische Standards.
Probenahme und Stoffdosierung mit keramischen Membranscheiben von KERAFOL®

Mehr...
In zahlreichen industriellen und wissenschaftlichen Anwendungen sind präzise Probenahme und kontrollierte Stoffdosierung entscheidend für stabile Prozesse. Keramische Membranscheiben ermöglichen eine definierte Filtration sowie die gezielte Einbringung von Flüssigkeiten und Gasen. Dadurch wird eine zuverlässige Prozessüberwachung und -steuerung auch unter anspruchsvollen Bedingungen gewährleistet.
Processing of ceramic suspensions using Dynamic Crossflow Filtration (DCFF)
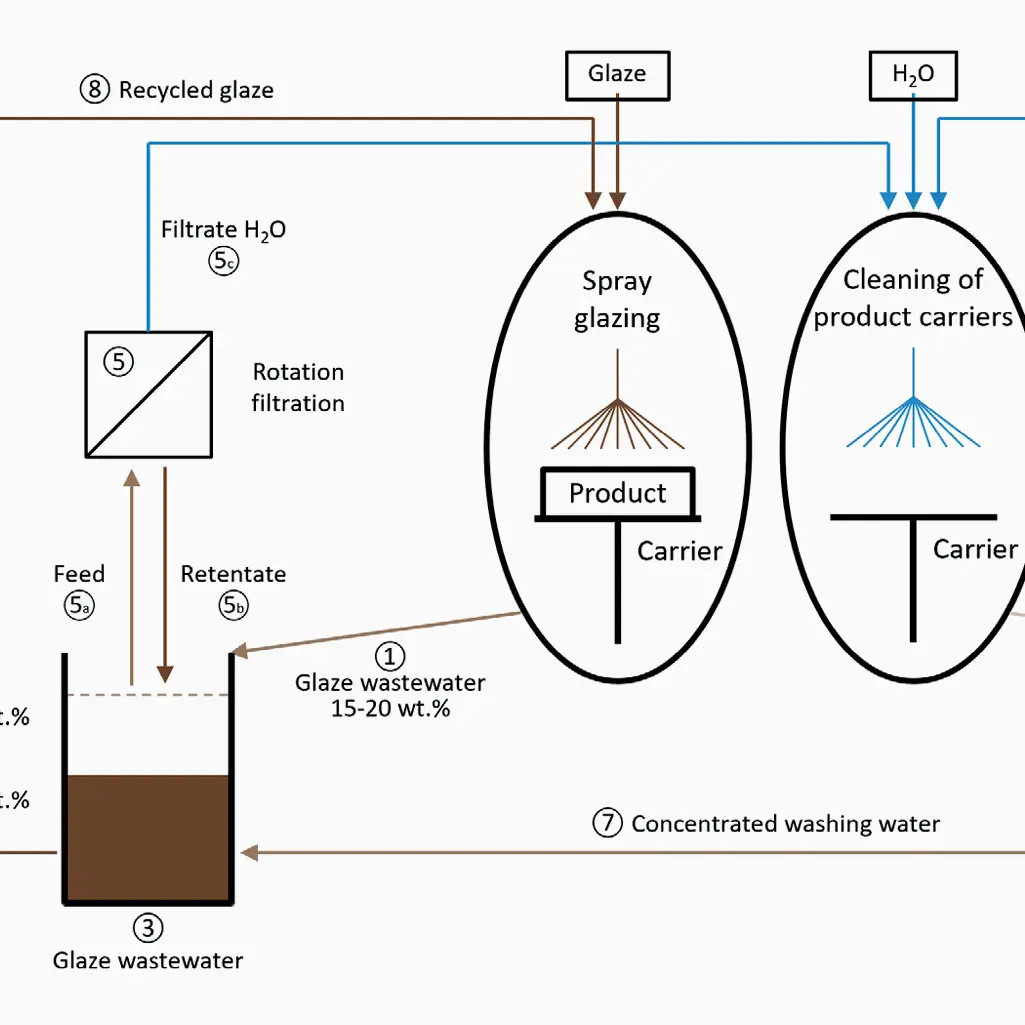
Mehr...
In ceramic production, wastewater containing valuable raw materials is generated, making recovery increasingly important for economic and environmental reasons. Advanced filtration technologies such as Dynamic Crossflow Filtration enable efficient treatment and reuse. This allows raw materials to be recovered and closed-loop processes to be established.
Spezifische Wärmeleitfolienzuschnitte für TO-Bauteil

Mehr...
TO-Gehäuse wie TO-220 oder TO-247 sind in der Leistungselektronik weit verbreitet. Die Application Note zeigt, wie KERATHERM-Folien thermische Leitfähigkeit und elektrische Isolation optimal kombinieren, um eine effiziente Kühlung und einfache Montage direkt auf den Standardpackages zu ermöglichen.
Entwickelt für unterschiedliche Leistungsklassen, bieten die Folien eine flexible, automatisierbare Lösung für moderne Leistungselektronik.
Sustainable Manure and Digestate Treatment through Innovative Filtration Technologies

Mehr...
In agriculture and biogas production, large volumes of manure and digestate must be processed efficiently and in an environmentally friendly way. Modern filtration technologies enable targeted separation into clean water and nutrient-rich concentrates. This allows resources to be used efficiently while significantly reducing environmental impact.
Übersicht:
Wärmemanagement für SiC-Halbleiter
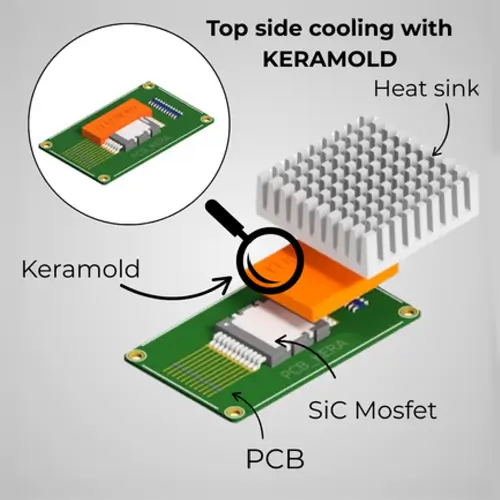
Mehr...
Bei leistungsstarkes Wide Band Gap Halbleiter wie SiC-oder GaN erfolgt die Wärmeabfuhr meist über die Chipoberseite. Die Application Note zeigt, wie KERAMOLD ® in Kombination mit dem Overmolding Prozess aktive Bauteile passgenau schützen und kühlen kann.
Mit KERAMOLD ® lassen sich Wärmeleitung, elektrische Isolation und mechanische Stabilität in einem Prozessschritt kombinieren – und damit neue Freiheitsgrade für die Gestaltung leistungsfähiger Top Side Cooling-Lösungen erschließen.
Wärmemanagement für SiC-Halbleiter im 800V Bereich
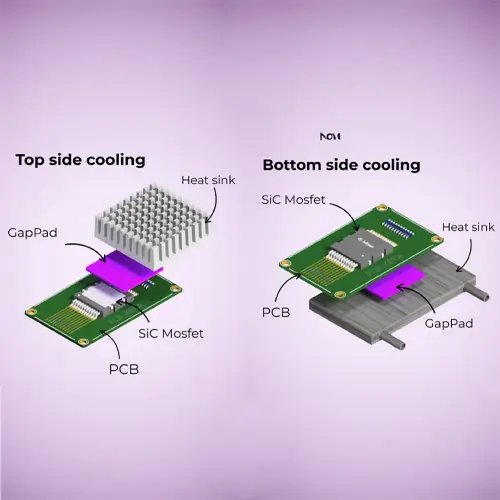
Mehr...
Bei leistungsstarkes Wide Band Gap Halbleiter wie SiC-oder GaN erfolgt die Wärmeabfuhr meist über die Chipoberseite. Die Application Note zeigt, wie Hybridfolie und Hybridkeramik als zusätzliche Materialoptionen neue Gestaltungsmöglichkeiten im Top-Side-Cooling eröffnen – insbesondere dort, wo thermische Performance, Isolation und Aufbauvarianten flexibel kombiniert werden sollen.
Ein kompakter Überblick für Entwickler, die ihr TIM-Portfolio um weitere Lösungsansätze erweitern möchten.